5分钟IN科普 | 先进封装,助力多芯片系统“万马奔腾”
2026-03-13 来源:微信公众号:英特尔中国
最近,我们通过“5分钟IN科普”系列,介绍了英特尔多芯片系统背后包含的数项底层技术。在晶体管层面,RibbonFET全环绕栅极晶体管和PowerVia背面供电技术带来了性能更强、体积更小的晶体管;硅光技术的创新,则为在芯片间长距离、低功耗传输海量数据铺平了道路。
那么,多芯片系统本身又是如何“诞生”的?怎么才能让堆叠起来的芯片“心往一处想,劲往一处使”,组成一个妥善运转的系统,完成既定的工作负载?


随着晶体管微缩的难度不断加大,人们正在探索提高芯片系统集成度和互连密度的新路径。一项技术脱颖而出,成为半导体行业的新宠,它就是先进封装(advanced packaging)。虽然也叫“封装”,但它和传统意义上用于保护芯片的封装工艺有着巨大的差别。传统封装的核心是“保护与连接”,而先进封装的目标是“构建与集成”,它本身已成为设计高性能芯片系统的关键一环,决定了系统的性能、功耗与形态。
传统封装:保护与连接
传统意义上,封装是半导体制造后端流程中的重要一环。通过将单个或多个芯片固定到一个封装中,能够为它们提供多重的保护,避免其受到高温、高压,以及灰尘、湿气等等外部环境因素的破坏。同时,封装也起到连接电路的作用,将芯片与电子产品中的其它组件连接起来。
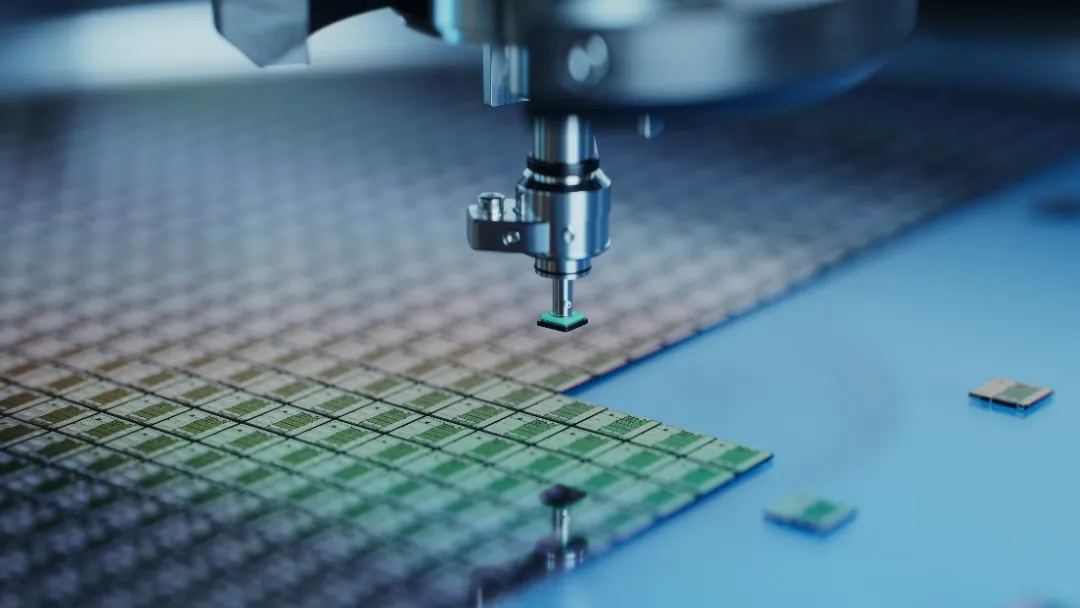
传统的封装工艺包含三大阶段,有点像盖房子的收尾阶段,比如加固墙体和地基:
· 芯片贴装(chip attach):将芯片及电容等必要元件固定在封装基板上。
· 环氧树脂封装:在芯片与基板之间注入环氧树脂,以消除微小气隙,确保物理压力在裸片上均匀分布。
· 封盖贴合(lid attach):在芯片表面涂上热界面材料,然后安装散热器,能够将芯片工作时产生的热量传导出去。
从“保护”到“构建”:先进封装如何革新系统集成
然而,面对AI、高性能计算等领域对算力、能效和集成度爆炸式增长的需求,仅仅实现“保护与连接”的传统封装已力不从心。这就催生了更高层次的封装理念——先进封装。其核心思想,是从“封装一个现成的芯片”转变为“用封装技术来构建一个完整的芯片系统”。
一座城市里包含住宅区、商业区、文教区、工业区等不同的区域,如何通过道路和桥梁将它们高效连接起来,满足居民日常工作和生活的需求,是城市规划的重要课题。
在一个多芯片系统中,
多个芯粒通过英特尔的EMIB 2.5D封装技术被连接起来
先进封装在多芯片系统中的作用正类似于此。与将所有功能都集成在一块大芯片上的“系统级芯片”不同,先进封装支持“芯粒”设计范式:将复杂系统分解为多个专门的芯粒,每个芯粒可以根据具体功能灵活选择最适合的制程工艺,独立优化。最后,像搭积木一样,通过先进封装技术将这些芯粒高密度、高性能地集成在一起。这种“异构集成”不仅提高了设计灵活性和良率,更通过缩短芯片间互连距离,显著提升了整体系统的性能和能效。
英特尔先进封装“团队”
在先进封装领域,英特尔有着丰富的技术积累,能够为客户提供定制化的系统级解决方案。
·EMIB 2.5D:EMIB全称“嵌入式多芯片互连桥接”,这项技术有点像芯片间的“地下通道”,通过在芯片下方的基板内嵌入一块小芯片,在两块水平并排的芯片间实现互连。这块小芯片又称“硅桥”(silicon bridge)。EMIB技术的演进版本包括EMIB-M,在硅桥中了采用MIM电容,以及EMIB-T,在硅桥上加装了硅通孔(TSV),能够满足多样化的需求。
·Foveros-S 2.5D:Foveros-S是英特尔实现硅中介层技术的一种方式,将平面上的多个芯片通过一块不负责计算的硅基底板连接在一起。Foveros-S的优势在于面积大,可支持多个光罩尺寸,就像一个“标准的大型连接底板”。
·Foveros-R 2.5D:Foveros-R采用了重布线层中介层。与只有固定孔位的一般硅中介层不同,重布线层中介层在硅中介层之上添加了一层可自定义的金属布线层,支持灵活调整每块芯片I/O点的位置,从而能够更灵活地实现不同尺寸、不同工艺芯粒的互连,更好地满足异构计算的需求。这项技术预计将在未来几年内投入量产。
·Foveros Direct 3D:Foveros Direct技术可以通过混合键合实现芯片垂直层面的3D堆叠,就像盖楼房一样,直接在垂直方向上将不同功能的芯粒(如计算芯粒与缓存)键合在一起,实现极高的互连带宽和密度。
·EMIB + Foveros 混合封装:英特尔可将EMIB(2.5D水平互连)与Foveros Direct(3D垂直堆叠)等技术在同一封装中协同使用,实现更复杂的异构集成,适合需要在单个封装中集成多个3D堆叠模块的尖端系统。
在“硬科技”之外,“软标准”同样重要,芯粒间需要高带宽、低延迟的通信协议。英特尔还参与发起了UCIe(通用芯粒互连)标准,提出了物理层、协议层等标准,旨在确保不同供应商的芯粒可以像“通用零件”一样无缝协作。
在这“万马奔腾”、追求极致算力的时代,先进封装技术正成为释放AI、机器人、自动驾驶等新兴技术无限潜能的关键引擎。它将不同的计算单元紧密连接,协同工作,共同奔向更加智能的未来。
/转载请注明出处/
- 嵌入式的风向变了:2026纽伦堡嵌入式展透露这些趋势
- 高通确认不在GDC 2026发布新款骁龙G系列掌机处理器SoC
- 行业评论 从工具到平台:如何化解跨架构时代的工程开发和管理难题
- 阿里达摩院发布玄铁C950,打破全球RISC-V CPU性能纪录
- 面向嵌入式部署的神经网络优化:模型压缩深度解析
- Mujoco中添加Apriltag标签并实现相机识别教程
- 摩尔线程MTT S5000全面适配Qwen3.5三款新模型
- 英飞凌与宝马集团携手合作,基于Neue Klasse架构塑造软件定义汽车的未来
- 物理AI仿真新突破:摩尔线程与五一视界共建全栈国产化生态
- 爆火的OpenClaw! 告别云端,米尔RK3576开发板本地部署
- Altera 与 Arm 深化合作,共筑 AI 数据中心高效可编程新方案
- 莱迪思加入英伟达 Halos生态系统,通过Holoscan传感器桥接技术提升物理人工智能安全性
- 芯科科技闪耀2026嵌入式世界展 以Connected Intelligence赋能,构建边缘智能网联新生态
- 边缘计算主机盒选购指南:五大核心指标解析
- Arm AGI CPU 更多细节:台积电 3nm 制程、Neoverse V3 微架构
- Arm AGI CPU 重磅发布:构筑代理式 AI 云时代的芯片基石
- Arm 拓展其计算平台矩阵,首次跨足芯片产品
- 阿里达摩院发布RISC-V CPU玄铁C950,首次原生支持千亿参数大模型
- 边缘 AI 加速的 Arm® Cortex® ‑M0+ MCU 如何为电子产品注入更强智能