硅芯科技发布2.5D/3D EDA⁺新范式,重构先进封装协同设计体系
2025-11-27 来源:EEWORLD
11月20日至21日,ICCAD-Expo 2025 在成都中国西部国际博览城顺利举办。大会以“开放创新,成就未来”为主题,吸引2000余家集成电路企业与6300多名专业观众到场,汇聚产业链上下游力量,全面呈现国内芯片设计与先进封装领域的最新趋势。

大会现场
展会期间,硅芯科技创始人兼首席科学家赵毅博士受邀出席高峰论坛,并正式对外发布“2.5D/3D EDA⁺新范式,重构先进封装全流程设计、仿真与验证的协同创新”。系统阐述如何将先进封装工艺、Chiplet互联、多芯粒系统与EDA工程体系重新整合为一个可闭环的协同框架。


硅芯科技创始人赵毅高峰论坛演讲现场
先进封装时代:EDA⁺新范式重构设计逻辑
赵毅博士指出,随着 AI、智能汽车、高带宽存储等应用推动算力需求攀升,先进封装已经从后端封测环节转为前端系统架构设计。伴随2.5D/3D先进封装的快速产业化,多家工艺厂虽然已具备成熟的关键工艺能力,但在实际用户端落地时,却普遍面临“工艺复杂、设计难以调用”的鸿沟;与此同时,大量 AI、边缘计算与高带宽场景的设计公司也发现,在跨工艺、跨介质的多芯粒布局布线、互联分析和系统级可靠性验证方面,传统EDA方法已经难以应对。
在此背景下,先进封装EDA必须重构设计范式,形成跨工艺、跨芯粒、跨物理场的系统协同:以工艺为基础、以设计场景为驱动、以跨芯粒协同为目标,使设计端能够以统一的数据模型使用封装工艺,使工艺端能够通过标准化接口进入多芯粒流程,使多物理场、互联、可靠性等关键环节提前进入设计早期,从而形成真正能落地的工程体系。
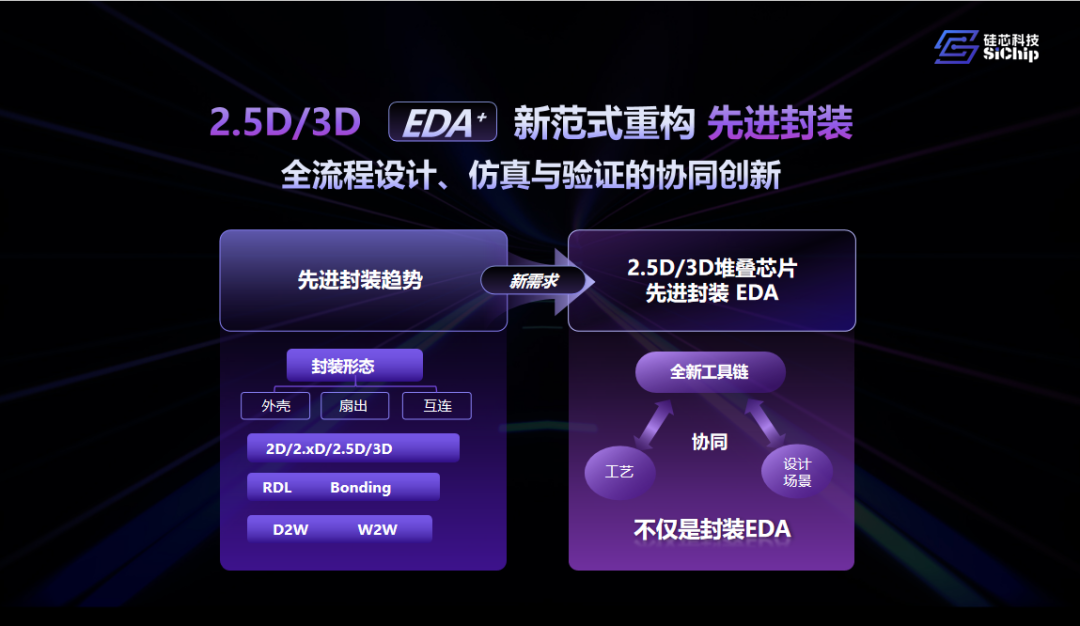
2.5D/3D EDA⁺新范式重构先进封装
2.5D/3D EDA⁺新范式,推动先进封装工艺制造与场景应用协同
目前,硅芯科技已与多家先进封装厂展开合作,通过构建覆盖 RDL、硅中介层、玻璃基板、TSV/TGV 等多类工艺的标准化数据库,把原本分散在流程文档和经验规则中的工艺参数转换成可被设计工具直接调用的模型。随着这些模型接入 3Sheng Integration 平台,设计端能够在早期完成跨工艺互联规划、寄生参数评估和热应力预测,大幅减少后期返工,使多芯粒系统从设计到验证能够顺畅推进。

2.5D/3D EDA⁺新范式
这一机制让工艺规则与设计流程实现有效衔接,使多芯粒系统能够在一致的数据基础上完成从架构规划到设计、仿真与验证的全流程协同。无论是以 Chiplet 为核心的多芯粒系统、面向大算力的 AI 架构,还是高带宽存储与异构集成应用,EDA⁺ 所带来的工艺—设计协同正在让先进封装从“单点突破”迈向“可规模化的体系化应用”。随着先进封装带来新的协同需求,EDA 工具之间原本清晰的分工开始出现交叉。
在工艺与设计协同加速后,2D与3D EDA是否会走向横向协同?
在ICCAD媒体采访中,硅芯科技也分享了对这一问题的看法。在工艺能力不断演进、多芯粒设计快速普及的背景下,传统单芯片EDA在新的3D/多芯粒需求下并非被替代,而是更可能与多芯片设计方法形成互补。许多在单芯片流程中已高度成熟的能力,如验证、仿真和版图方法学,在多芯片架构中依然是每颗 die 的基础环节,同时还需要与跨die 的系统级流程协同运作。随着工艺数据和设计数据的协同基础逐步建立,这些单芯片方法与多芯片设计之间的边界开始变得更具弹性,也为两类工具的横向组合创造了空间。

ICCAD媒体采访

半导体行业观察直播采访
赵毅博士提到,多芯片设计的兴起让行业出现了新的技术结合点:传统单芯片工具在复杂系统下能够提供稳定的底层能力,而硅芯科技在多芯片规划、互联与跨工艺仿真方面的优势则补足了系统级设计的关键环节。相比依赖大规模并购整合,他认为围绕具体场景开展工具级协作,可能更符合当前国产 EDA 的发展节奏。例如在多芯片互联和跨工艺仿真这类具体场景中,单芯片工具更擅长处理每颗 die 的时序、版图和功能验证,而多芯片设计工具则承担芯片间互联规划、电源/信号完整性以及热行为等系统级分析。而这种从具体场景出发的工具级协同,也进一步延伸为产业参与者之间更广泛的合作需求。


硅芯科技展位
面向未来,硅芯科技将继续在先进封装的工艺、设计与验证环节推动产业上下游协同,同时也希望与更多本土 EDA 企业协同合作,以共同完善国产工具链的能力布局。通过纵向联动产业链、横向连接生态伙伴,推动国内半导体构建更具协同力的“合纵连横”格局,为先进封装与国产 EDA 的进一步发展提供持续动力。
- 硅芯科技赵毅:共建“EDA+”体系,迎接产业新范式
- 国内首款Agentic AI自研EDA平台,合见工软发布智能体UDA 2.0重塑芯片设计范式
- 从概念到芯片:新思科技EDA+车规IP赋能芯粒架构汽车SoC设计
- 伴芯科技正式发布AI智能体 以大模型重构芯片设计效率
- 锐成芯微杨毅:以全栈 IP 布局赋能 AIoT 3.0 演进
- 合见工软徐昀:国产EDA赋能,筑牢智算产业自主根基
- 启芯领航廖鼎鑫: 国产 EDA 替代不能依赖情怀,更需要产品实力
- 巨霖科技孙家鑫:EDA行业只有第一没有第二
- 鸿芯微纳研发副总裁冯春阳:打造纯血数字后端全流程EDA工具链,迎接后摩尔时代
- ADI启用泰国新工厂,强化全球制造韧性
- 半年翻三倍!三星2nm良率涨至60%以上:紧追台积电
- 倪光南:半导体行业不再是先进制程包打天下的局面
- 意法半导体与英伟达合作加快物理AI全面普及和市场增长
- 贸泽电子荣获海关AEO高级认证 ——迈向国际贸易合规与供应链安全重要里程碑
- 全国首条 8 英寸硅光芯片量产线在苏州开工建设,预计 2027 年初投产
- 不只是PCB工具:拆解 Altium Develop 背后的平台化雄心
- Agentic AI时代,RISC-V如何突围?玄铁给出了答案
- All in AI再落一子:深度解读安谋科技“玲珑”V560/V760
- 资腾亮相SEMICON China展示CMP超洁净刷轮,助力先进制程良率提升

















